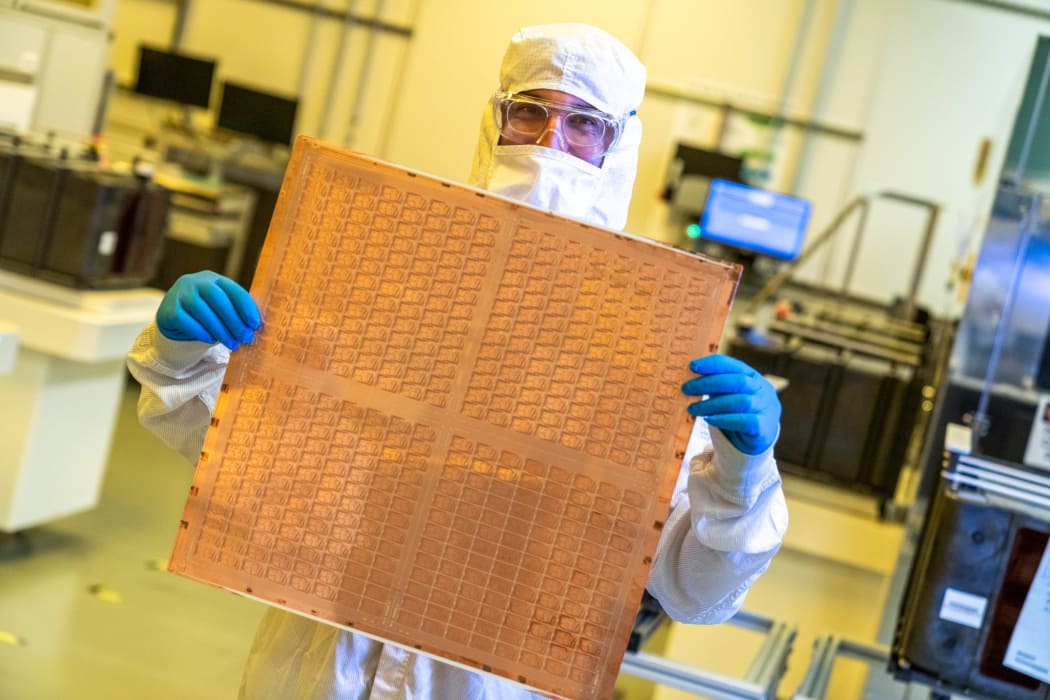
El sector de semiconductores se enfrenta a un nuevo punto de inflexión en el área de encapsulado avanzado, donde tecnologías como CoWoS de TSMC dominan actualmente la integración de memoria HBM y lógica en un mismo encapsulado. Sin embargo, el crecimiento de la IA está llevando estos diseños al límite en términos de complejidad, tamaño y consumo, obligando a replantear la base sobre la que se construyen los chips actuales.
En este contexto, los sustratos de vidrio emergen como una alternativa real. Según Amkor Technology, esta tecnología podría entrar en fase de comercialización en un plazo de tres años, lo que supondría un cambio profundo en la forma en la que se diseñan y fabrican los encapsulados para chips de nueva generación orientados a IA y centros de datos.
CoWoS y el límite del encapsulado actual

Fuente de la imagen: Intel
Las soluciones actuales como CoWoS 2.5D permiten integrar múltiples chiplets y pilas de memoria HBM, pero el escalado está alcanzando niveles extremos. Diseños futuros plantean configuraciones con más de 14 retículas y hasta 24 stacks de HBM, e incluso propuestas que superan las 60 pilas de memoria, lo que dispara la densidad de integración.
Este crecimiento aumenta la capacidad de cálculo, pero también introduce problemas estructurales. A medida que crece el encapsulado, se complican aspectos como la interconexión entre chiplets, la disipación térmica y la estabilidad mecánica, limitando la eficiencia global y elevando el riesgo de fallos en producción.
Complejidad, costes y tiempos de fabricación en aumento
El principal problema del modelo actual no es solo técnico, sino también económico. La complejidad de estos diseños eleva el coste de fabricación, al tiempo que alarga los ciclos productivos en procesos basados en RDL (Redistribution Layer), clave en el encapsulado moderno.
En algunos casos, el tiempo necesario para completar un chip puede superar un mes, lo que impacta directamente en la capacidad de escalar producción. A esto se suman factores como el estrés térmico, la deformación del encapsulado y el riesgo de warping, que dificultan aún más el desarrollo de chips avanzados.
Sustratos de vidrio: estabilidad térmica y menor deformación

Fuente de la imagen: The Elec
Los sustratos de vidrio se presentan como una solución directa a estos problemas. Frente a los materiales orgánicos tradicionales, ofrecen una mayor estabilidad térmica y una mejor resistencia a la deformación, dos aspectos críticos en encapsulados de gran tamaño.
Según responsables de Amkor Technology, los avances recientes han permitido superar dudas sobre su viabilidad, logrando una estabilidad tecnológica suficiente para plantear su uso en producción. Este punto es clave para su adopción en entornos industriales reales.
Intel impulsa la transición con Glass Core y EMIB
Intel es uno de los principales impulsores de esta tecnología, trabajando junto a Amkor en el desarrollo de sus sustratos Glass Core, integrados con su tecnología de encapsulado EMIB.
Este enfoque busca mejorar la interconexión entre chiplets y permitir diseños más complejos sin las limitaciones actuales. En el contexto de la IA, donde la densidad de integración y el ancho de banda son críticos, esta transición puede marcar una diferencia significativa frente a soluciones actuales.
Interés creciente de la industria en el nuevo estándar
El desarrollo de los sustratos de vidrio ha despertado el interés de múltiples fabricantes, que ven en esta tecnología una forma de superar los límites actuales del encapsulado basado en CoWoS.
A medida que crece la demanda de aceleradores de IA, centros de datos y hardware especializado, la necesidad de nuevas soluciones se vuelve urgente. En este escenario, los sustratos de vidrio se posicionan como una de las alternativas más prometedoras.

Pat Gelsinger, CEO de Intel, muestra una oblea de vidrio con pilas de circuitos fotónicos de silicio durante el evento Intel Innovation en San José (California), celebrado el 19 de septiembre de 2023. (Fuente de la imagen: Intel Corporation)
Un horizonte de tres años para cambiar el sector
El plazo estimado de tres años para su comercialización sitúa esta tecnología en un punto estratégico dentro del mercado. No es una solución inmediata, pero tampoco lejana, lo que la convierte en un elemento a seguir muy de cerca.
Si cumple lo prometido, los sustratos de vidrio podrían redefinir la base del encapsulado de chips, permitiendo superar limitaciones actuales en rendimiento, eficiencia térmica y escalabilidad, factores clave en la evolución del hardware para IA.
Vía: Wccftech











