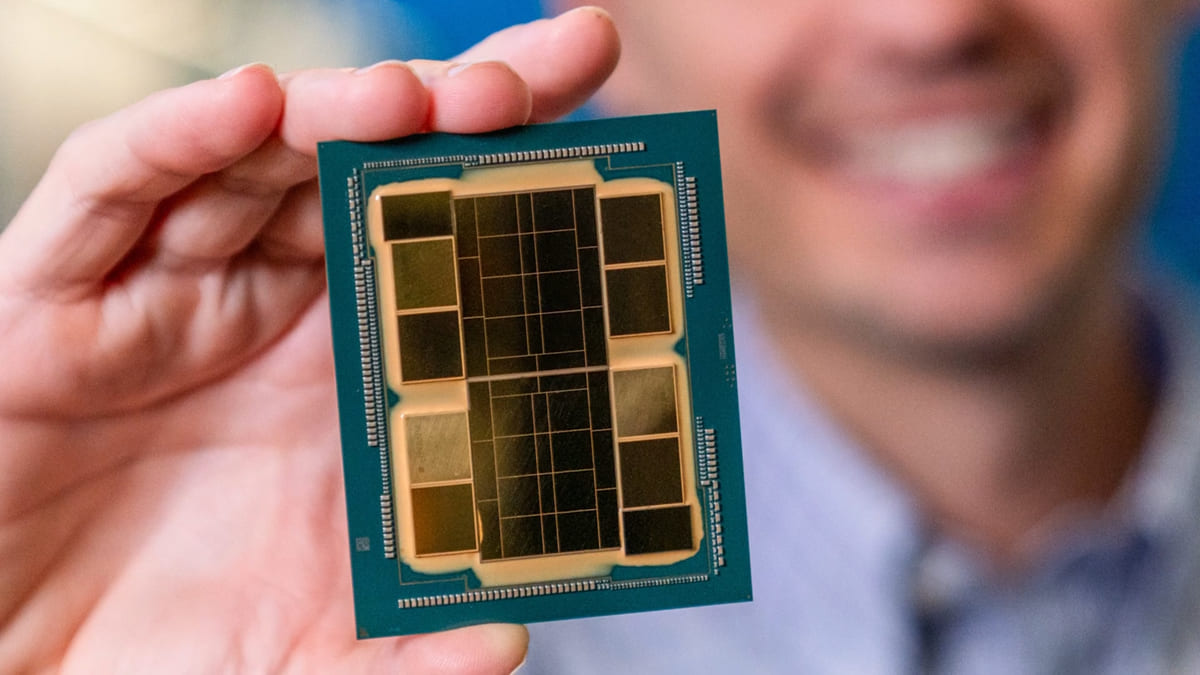
Intel ha vuelto a poner el foco en su tecnología de empaquetado avanzado EMIB (Embedded Multi-die Interconnect Bridge), comparándola directamente con los enfoques 2.5D tradicionales utilizados por otros fabricantes. El objetivo es claro: demostrar que su solución ofrece mayor flexibilidad, mejor escalabilidad y menores costes en diseños de chips complejos basados en chiplets.
La compañía ya ha empleado EMIB en productos como Ponte Vecchio, Sapphire Rapids, Granite Rapids, Sierra Forest y en futuras plataformas como Clearwater Forest, todas ellas orientadas a centros de datos y computación de alto rendimiento.
EMIB frente al empaquetado 2.5D clásico
En los enfoques 2.5D, ampliamente utilizados por la competencia como TSMC, los distintos chiplets se conectan mediante un interposador de silicio situado entre los chips y el sustrato del paquete. Esta técnica recurre a vías a través del silicio (TSV) para interconectar los distintos bloques funcionales.
Según Intel, este planteamiento presenta varios inconvenientes. El primero es el coste, ya que se utiliza silicio adicional cuya función principal es servir de soporte para las interconexiones. A medida que el tamaño del paquete crece, también lo hace la complejidad del diseño y el impacto negativo en los rendimientos de fabricación, especialmente por la presencia de TSV.
Además, el empaquetado 2.5D impone límites físicos al tamaño máximo del conjunto y reduce la libertad para combinar distintos tipos de chiplets, como lógica y memoria, en configuraciones muy heterogéneas.
EMIB: interconexión localizada y escalable
La propuesta de Intel con EMIB elimina la necesidad de un interposador de silicio completo. En su lugar, emplea pequeños puentes de silicio incrustados directamente en el sustrato del paquete, colocados únicamente donde es necesario interconectar dos chiplets.
Este enfoque permite escalar el diseño tanto en horizontal como en vertical, sin las restricciones que impone un interposador monolítico. La tecnología no es nueva, ya que EMIB está en producción en volumen desde 2017, pero Intel busca ahora reforzar su papel como pilar de sus futuras soluciones de empaquetado avanzado.
EMIB 2.5D y EMIB 3.5D: dos enfoques complementarios
Intel distingue actualmente entre EMIB 2.5D y EMIB 3.5D, cada uno pensado para escenarios distintos:
- EMIB 2.5D se orienta a la conexión eficiente entre chiplets complejos, tanto de lógica a lógica como de lógica a memoria HBM. Incluye variantes como EMIB-M, con condensadores MIM integrados, y EMIB-T, que añade TSV en el propio puente para facilitar la integración de propiedad intelectual procedente de otros diseños de empaquetado.
- EMIB 3.5D combina EMIB con la tecnología Foveros, permitiendo crear sistemas heterogéneos apilados en 3D dentro de un mismo paquete. Un ejemplo destacado es el Intel Data Center GPU Max Series, que emplea 47 tiles activos, más de 100.000 millones de transistores y hasta cinco nodos de proceso distintos en un solo encapsulado.
Coste, rendimiento y diseño como ejes clave
Intel resume las ventajas de EMIB en tres puntos principales: rendimientos de paquete dentro de rangos normales, oportunidades claras de reducción de costes y mayor simplicidad en el diseño frente a soluciones 2.5D tradicionales. Estos factores cobran especial relevancia en un momento en el que los chips avanzados tienden a crecer en tamaño y complejidad.
Con la compañía apostando cada vez más por su negocio de fundición y por nodos como 14A, el empaquetado avanzado se convierte en un elemento estratégico para competir con soluciones consolidadas del mercado. Tecnologías como EMIB-T y Foveros ya han despertado el interés de socios externos, reforzando la presión competitiva en un sector históricamente dominado por TSMC.
El empaquetado, pieza clave del futuro del silicio
Más allá del debate técnico, el mensaje de Intel es claro: el futuro del rendimiento no depende solo del nodo litográfico, sino de cómo se integran y conectan los chiplets. En ese contexto, EMIB se presenta como una alternativa más flexible frente al empaquetado 2.5D clásico, especialmente para chips de gran tamaño y alta heterogeneidad.
El éxito de esta estrategia dependerá de su adopción real por parte de clientes externos, pero Intel deja claro que el empaquetado avanzado será uno de los pilares sobre los que pretende construir su próxima generación de silicio fabricado en suelo estadounidense.
Vía: Wccftech